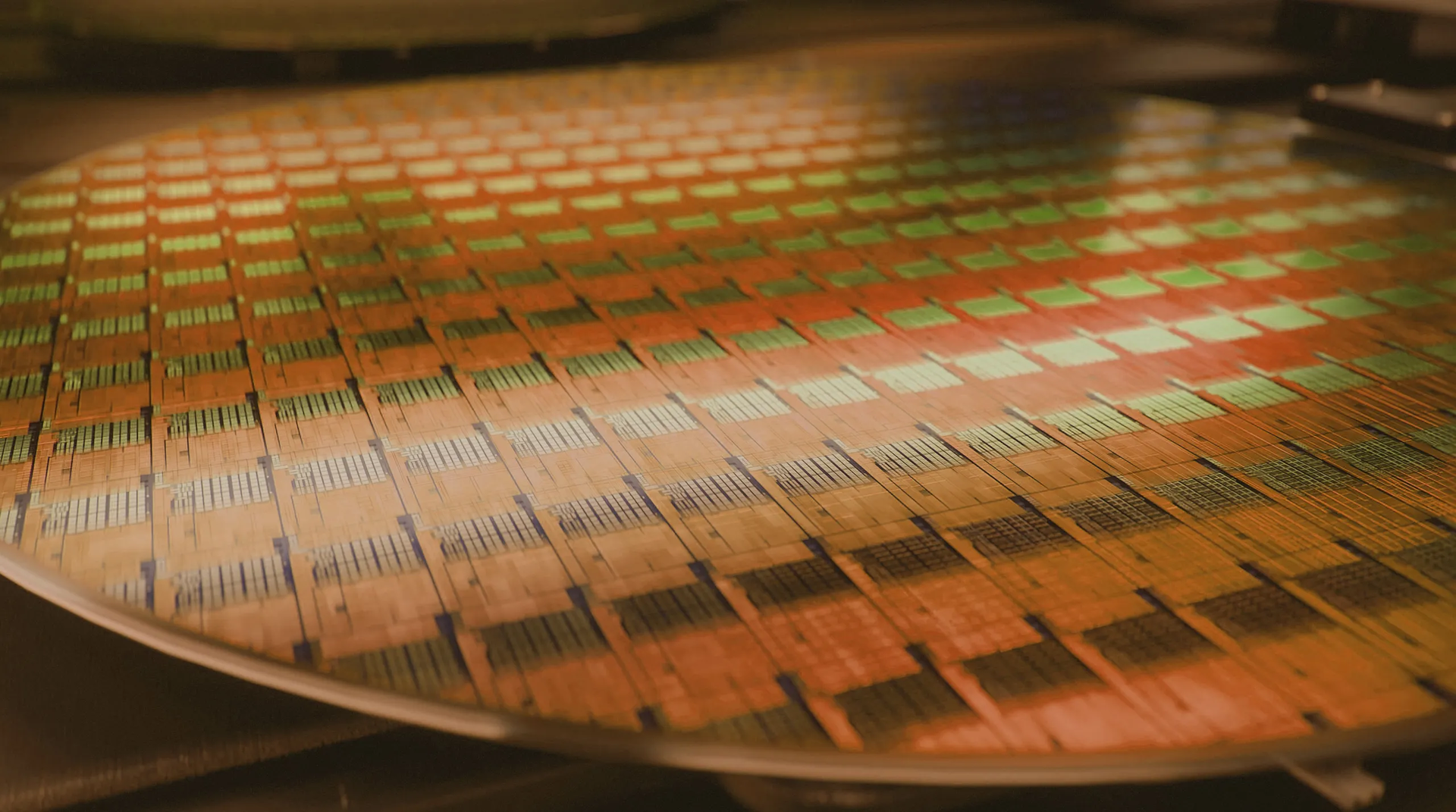
光散乱計測
半導体デバイス内部の構造が原子スケールの寸法に近づくにつれ、パターン形状をナノメートル単位で制御・検証することが、歩留まりと性能を左右する重要な要素となっています。電子顕微鏡(CD-SEM)などの画像化技術は、大規模なモデリングを必要とせず直接可視化できますが、統計的プロセス制御(SPC)に使用するには、スループット、ウェーハ全体への適用、装置間の整合性といった面で課題を抱えています。
光散乱計測法(OCD計測法とも呼ばれる)は、高解像度分析と高スループット製造を繋ぐ重要な橋渡しを行う最新技術です。ウェーハ表面に精密に制御された光を所定の角度で照射し、反射回折光を分光的に、あるいは入射角または検出角の関数として検出することで、パターン形状に対応するスペクトル波形が得られます。これらのスペクトル波形を数学的波面モデルと比較することで、サブナノメートルの精度で特徴サイズや形状などの臨界寸法を正確に導出します。この技術は周期的な構造に適しており、かつスループットが高いため、フルウェーハ マッピングが可能になり、側壁角度、フッティング、コーナーの丸み、レジスト損失などのインライン プロファイリングが可能になります。
半導体製造における散乱計測の重要性
光散乱計測法(OCD計測法)はリソグラフィ、エッチング、デポジション、CMP(化学機械平坦化/研磨)工程におけるプロセス制御の重要な計測手法となっています。デバイス構造が微細化し複雑になるにつれ、すべてのウェーハまたはすべての層を直接計測することはもはや現実的ではありません。OCDは以下を提供します。
- 大面積ウェーハ全体にわたる高速かつ非破壊的な計測
- サブナノメートル精度による限界寸法(CD)およびオーバーレイモニタリング
- 高スループットでインライン統合に最適
- モデルベースの再構成により完全な3Dプロファイル情報を提供
- ツール間のマッチングで統計的プロセス制御(SPC)に最適
主なアプリケーション:
- リソグラフィのフォーカスおよびドーズ量制御
- エッチング深さおよび側壁角度のモニタリング
- フィルムスタックおよび多層膜の厚さ測定
- オーバーレイ計測および限界寸法均一性制御
光散乱計測におけるレーザーの役割
あらゆる光散乱計測ツールの心臓部には、精密に制御された光源があります。レーザーは、コヒーレンス、安定性、スペクトル純度、そして偏光制御といった、正確な回折計測に不可欠な要素を兼ね備えているため、OCD(Optical Ctitical Dimensions)測定用の照明として最適です。
主なレーザー特性:
- 高い空間的および時間的コヒーレンス → 鮮明な回折パターンと安定した強度信号を確保します。
- 狭い線幅 → 波長依存モデリングのためのスペクトル精度を提供します。
- 優れた波長安定性 → インライン計測における再現性に不可欠です。
- 偏光制御 → 直線偏光または円偏光により、構造の配向や材料コントラストに対する感度が向上します。
- ビーム品質 → 均一な照明と再現性の高い回折条件を確保します。
- 多波長対応 → 単層の限界寸法制御から複雑な多層膜解析まで、この技術を拡張します。
光散乱計測は、測定された光スペクトルとシミュレーションモデルの比較に基づいているため、レーザー光源の精度と安定性が計測精度を直接決定づけます。
OCD測定システムで使用されるレーザーの種類と波長
| レーザー種別 | 波長レンジ | アプリケーション | 主な特徴 |
TOPTICA社推奨レーザー製品 |
|---|---|---|---|---|
| VIS & IR シングルモード半導体レーザー | 420–1064 nm | 高速CD制御とインラインモニタリング | 優れたビーム品質、コンパクト、OEM統合、ファイバー結合 | iBeam smart, iChrome |
| UV 単一周波数CWレーザー | 266-405nm | 浅いトレンチ、マスク、レジスト層の計測 | 高空間分解能、最大コヒーレンス長、ファイバー結合 | TopWave, TopMode |
|
HeNe レーザーまたは HeNe代替 レーザー |
632.8 nm | 校正用、参照システム用 | 低コスト、波長精度、長期安定性 | iBeam smart WS, DFB Pro 633 |
| ファイバーレーザー (媒質: Yb, Er) | 1030–1550 nm | フイルム膜厚と埋め込み界面の解析 | 高出力、長いコヒーレンス長、低位相ノイズ | ALS |
| ワイドレンジ波長チューニングが可能なOPOレーザー | 190–2000 nm | 多層積層構造の分光散乱計測 | 広帯域波長チューニング性、偏光制御 | TOPO, TOPO Smart |
VIS & DUV レーザー
可視光線および紫外線レーザーは、半導体の最小構造(通常20nm未満)を解像する必要がある場合、またはプロセス波長がリソグラフィ露光波長に対応する場合(例:193nm ArFプロセス)に使用されます。
波長が短いため、横方向空間解像度が向上し、表面および側壁の特徴に対する感度が向上します。DUV光散乱計測法は、フォトマスクおよびレジストの特性評価に特に重要です。
NIR レーザー
近赤外レーザー(1030~1550 nm)は薄膜積層体のより深部まで到達するため、深部に埋め込まれた界面、膜厚、多層の光学特性を正確に測定できます。ファイバーベースの単一周波数レーザーは優れた長期安定性を備えており、量産規模のOCD測定ツールに最適です。
最先端アプリケーションと要件
1. EUVリソグラフィーとマスク計測
次世代のOCD測定ツールは、EUV(13.5 nm)リソグラフィー向けに開発されています。EUVマスクと多層膜ミラーの特性評価において、計測システムはレーザー駆動プラズマ光源と、nmスケールの欠陥やパターン歪みを解析できる短波長光学モデルにますます依存するようになっています。
2. 3D NANDと高度なパッケージング
対象デバイスが3D垂直構造や高アスペクト比構造へと進化するにつれ、散乱計測はより深く探査し、より複雑な形状を解釈する必要が生じています。
これにより、深い溝や非平面地形を解析できる、多角度、多波長、偏光分解可能なレーザーシステムの需要が高まっています。
3. 機械学習とAIの統合
AI支援によるテクノロジーの再構成は、散乱計測データの解釈に革命をもたらします。シミュレーションと実測スペクトルの大規模データセットを組み合わせることで、ニューラルネットワークアルゴリズムは構造パラメータをリアルタイムで抽出し、計算オーバーヘッドを削減し、ノイズに対する堅牢性を向上させます。
4. 波長掃引光源および周波数コムレーザー
最新の波長掃引レーザーと周波数コムレーザーは、比類のない波長精度と再現性を実現します。原理的に精密に校正されたスペクトル間隔により、ピコメートル単位の精度で絶対的な厚さと距離の測定が可能になり、計測性能の新たな基準を確立します。
5. インラインおよびインシチュー計測
コンパクトで高度に工業化されたファイバー結合型レーザー散乱計は、プロセスツール(エッチング、デポジション、リソグラフィー)に直接統合されるケースが増えており、リアルタイムフィードバックと閉ループプロセス制御を可能にしています。
この進化により、計測技術は下流の検査工程からプロセス最適化のアクティブなコンポーネントへと変化しています。
Conclusion
光散乱計測(OCD)は、半導体製造において最も重要な計測技術の一つとなり、あらゆる特徴、薄膜、そしてインターフェースが、今日の最先端ノードに求められる精度を満たすことを保証します。レーザー光がナノ構造とどのように相互作用するかを解析することで、OCDは非破壊、高スループット、そしてサブナノメートル精度のプロセス制御を実現します。
レーザーはこの最新技術の基盤となるものです。その高コヒーレンス、スペクトル純度、波長チューナビリティ、そして偏光制御により、レーザーはあらゆる技術世代における散乱計測のための理想的な光源となっています。
チップ設計が進化を続け、寸法の小型化、3Dアーキテクチャ、そしてより複雑な材料積層が進むにつれて、レーザーベースのOCD計測は、半導体製造を原子スケールへと導き、あらゆる段階で精度、効率、そして革新性を確保する上で不可欠なものとなるでしょう。