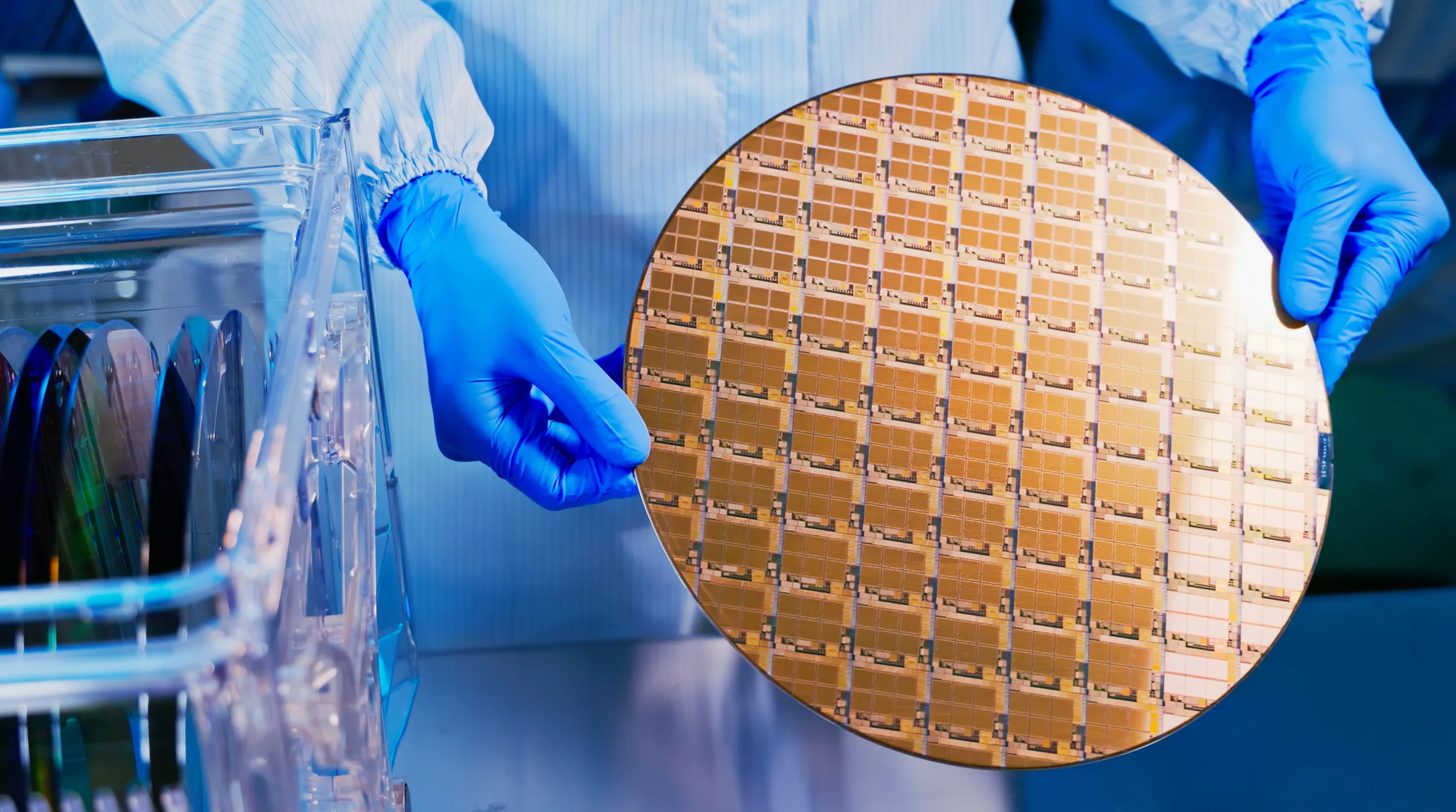
エリプソメトリ―
半導体製造において、薄膜の精密な制御は、あらゆるプロセスステップの成功を左右します。ゲートスタックの酸化膜の厚さ、誘電体層の屈折率、多層コーティングの均一性など、ナノメートル単位の精度が重要になります。
このため、エリプソメトリーは、半導体業界における非破壊高精度計測において、最も強力かつ不可欠なツールの一つとなっています。偏光が材料表面とどのように相互作用するかを計測することで、膜厚、光学定数、組成、界面品質などに関する詳細な情報が得られます。
エリプソメトリーの原理と重要性
エリプソメトリーは、物質からの反射または透過による光の偏光の変化を測定します。偏光が表面に当たると、p偏光(平行偏光)とs偏光(垂直偏光)の成分はそれぞれ異なる振幅と位相変化を起こします。これらの変化を解析することで、エリプソメトリーは試料の光学特性と構造特性を非常に高い精度で抽出します。膜厚で0.1Å以下の精度が得られる場合も少なくありません。
そのため、この技術は、前工程の成膜やエッチングから後工程のパッケージングに至るまで、半導体製造におけるプロセス制御と品質保証の中核を成しています。エリプソメトリーは、以下の特性評価に日常的に用いられています。
- ゲート酸化膜および誘電体スタック
- フォトレジストおよびハードマスク層
- エピタキシャル膜およびヘテロ構造
- パッシベーションコーティングおよびウェーハ接合界面
エリプソメトリーは非接触、高速、非破壊であるため、研究開発環境と量産環境の両方に適用でき、デバイスの性能と歩留まりの一貫性を確保します。
エリプソメトリーにおけるレーザーの役割
初期のエリプソメーターでは広帯域ランプとモノクロメーターが使用されていましたが、今日の半導体産業の要求(微細化、測定高速化、構造化表面)により、レーザーが照明光源として選ばれるようになりました。レーザーは、分光エリプソメトリーとイメージングエリプソメトリーの両方に独自の利点をもたらします。
- 高い空間コヒーレンスにより精密な焦点合わせが可能になり、パターン化されたウェーハやデバイス領域の微細化が可能になります。
- 高い時間コヒーレンスと狭い線幅により、偏光測定における正確な位相と振幅の検出が保証されます。
- 優れた波長精度と出力安定性により、製造環境において再現性が高くドリフトのないデータが得られます。
- 偏光純度(消光比100:1以上)により、p成分とs成分のクリーンで正確な分析が保証されます。
- 波長可変レーザー光源を利用することで、広いスペクトル範囲にわたる高速スキャンが可能になり、高スペクトル分解能を備えた完全な分光エリプソメトリーへの拡張が可能になります。
これらの特性により、レーザーベースのエリプソメトリーは従来のランプベースのアプローチよりもはるかに高感度、コンパクト、多用途であり、高度な半導体プロセスで要求されるナノメートルおよびサブナノメートルの精度に最適解となります。
レーザーエリプソメトリーの種類
1. 単波長エリプソメトリー
波長固定レーザー(従来は632.8 nmのHeNeレーザー、または405~785 nmのダイオードレーザー)を使用し、製造装置における高速かつ高精度な膜厚モニタリングを実現します。
- 利点:小型、高速、そしてコスト効率に優れています。
- 代表的なレーザー:
- 単一周波数ダイオードレーザー(出力1~10 mW、線幅< 1 MHz)
- 偏光消光比> 100:1により、正確なΨおよびΔ測定が可能
- 用途:酸化膜、窒化膜、またはレジスト層の厚さのリアルタイムモニタリング、CMP(化学機械平坦化/研磨)のエンドポイント検出、プロセス均一性制御
2. 分光エリプソメトリー
この技術を広い波長範囲(通常190~2000 nm)に拡張し、光学定数(n、k)および多層膜スタックの測定を可能にします。
- レーザーの種類:
- 音響光学またはフィルターベースの波長選択機能を備えた波長可変ダイオードレーザーまたはスーパーコンティニューム光源
- 深紫外(DUV)から近赤外(NIR)までをカバーする光パラメトリック発振器(OPO)または第二高調波 / 第四高調波レーザー
- 性能:
- 波長精度 < 0.001 nm
- 発振線幅 < 1 MHz
- 出力安定性 < 0.1%
- 用途:High-k/メタルゲート特性評価、複雑な多層膜の光学定数モデリング、先端薄膜の組成分析
3. イメージングエリプソメトリー
エリプソメトリーと顕微鏡および走査光学系を組み合わせることで、膜厚と屈折率の空間分解2Dまたは3Dマップを提供します。
- レーザー:優れたビーム品質と低スペックル(”SKILL”スペックル低減技術の使用など)を備えた可視およびN近赤外CW光源(405~1064 nm)。
- 分解能:
- 横方向:< 1 µm(スポットサイズの制限あり)
- 縦方向(膜厚):< 0.1 nm
- 用途:パターン化ウェーハ解析、欠陥位置特定、不均一性マッピング、局所薄膜計測。


エリプソメトリーにおける可視レーザーと深紫外レーザー
可視光線および近赤外レーザーは幅広い材料、特にパターン化されたウェーハ、透明誘電体、プロセス制御工程において、高精度かつ柔軟な測定を目的とした測定に使用されます。これらの波長は試料表面に対する影響がソフトかつ、吸収を最小限に抑え、標準的な光学部品と互換性があります。
深紫外(DUV)レーザー(通常193 nmまたは266 nm)は、非常に薄い層や吸収層をプローブする場合、または測定波長をリソグラフィ露光波長(例えば、ArFベースの193 nmプロセス)と一致させる必要がある場合に必要です。DUVエリプソメトリーは、特に以下の用途に有効です。
- 薄いレジストおよび反射防止コーティングの特性評価
- バンドギャップに関連する光学特性の測定
- 光誘起膜変化およびUV感受性層の評価
波長が短いため、材料中の電子遷移にアクセスできるようになり、オングストロームレベルでの組成および厚みに対する感度が向上します。
新たなアプリケーションと将来の技術要件
半導体アーキテクチャが平面トランジスタから3D構造、そして高度なパッケージングへと進化するにつれ、エリプソメトリーは新たなレーザーベースのアプローチを通じて適応を続けています。
インラインおよびリアルタイムエリプソメトリー
小型で高速なレーザーエリプソメーターは、プロセスツールに直接統合されています。
- 要件:高速変調(>kHz)、小型光学系、堅牢な波長安定化。
- 利点:生産を中断することなく、薄膜成長およびエッチングプロセスを継続的にモニタリングできます。
赤外およびテラヘルツエリプソメトリー
スペクトル範囲を中赤外およびテラヘルツまで拡張することで、エリプソメトリーは自由キャリア吸収、ドーパントプロファイル、および埋め込み界面特性を調べることができます。
- レーザー光源:チューナブルOPO
- 用途:3D構造における非破壊ドーパントおよび導電率マッピング。
超高速・時間分解エリプソメトリー
フェムト秒レーザーを用いて、研究者たちは半導体材料におけるキャリアダイナミクスと光誘起変化を研究しています。
- メリット:光電子デバイスの性能に不可欠な超高速現象を理解できます。
Conclusion
レーザーエリプソメトリーは、半導体産業において計測技術の重要な柱となっています。層厚と光学定数をサブオングストロームの精度で測定できるため、研究と量産の両方において基盤技術となっています。
分光法による材料特性評価であれ、イメージング法による空間分解能の高いプロセス制御であれ、レーザーは最も要求の厳しい測定に必要なコヒーレンス、安定性、そしてスペクトル純度を提供します。
可視光から深紫外光まで、オフラインからインラインまで、実験室分析から生産品質管理まで、レーザーはエリプソメトリーによる目に見えないものを見ることを可能にし、半導体デバイスのナノメートル単位の構造まで完璧な状態を保証します。
半導体技術がますます薄型化、複雑化、そして3次元構造へと進むにつれ、エリプソメトリー検査におけるレーザーの役割は拡大し続け、次世代の精度、性能、そしてプロセスインサイトを推進していくでしょう。